当下CSP/BGA的工艺操作相关产品对于电子产品整体质量的要求越来越高,比如防震和焊盘和焊锡球之间的最低电气特性等。为满足这些要求,常在BGA芯片和PCBA之间填充底部填充环氧胶。
底部填充胶的应用原理是利用毛细作用使得胶水迅速流入BGA芯片底部,其毛细流动的最小空间是10um,加热之后可以固化。由于胶水不会流过低于4um的间隙,这也符合了焊接工艺中焊盘和焊锡球之间的最低电气特性要求,所以保障了焊接工艺的电气安全特性。
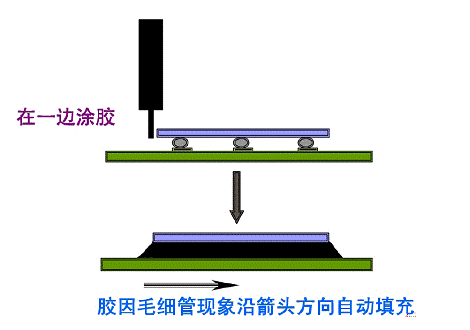
底部填充环氧胶使用方法
1.使用前先进行回温处理。室温放置至少4小时后再开封使用(回温时间与包装大小有关)。
2.回温过程保持胶水竖直放置,并及时清理包装外面的冷凝水。
3.打开包装后应一次性使用完,不能进行二次冷藏。